
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Epitaxné vrstvy: Základ pokročilých polovodičových zariadení
Obrázok 1: Ilustruje koreláciu medzi koncentráciami dopingu, hrúbkou vrstvy a prierazným napätím pre unipolárne zariadenia.

Príprava epitaxných vrstiev SiC primárne zahŕňa techniky, ako je rast odparovaním, epitaxia v kvapalnej fáze (LPE), epitaxia molekulárnym lúčom (MBE) a chemická depozícia z pary (CVD), pričom CVD je prevládajúcou metódou hromadnej výroby v továrňach.
Tabuľka 1: Poskytuje porovnávací prehľad hlavných metód prípravy epitaxnej vrstvy.

Prelomový prístup zahŕňa rast na substrátoch mimo osi {0001} pri špecifickom uhle sklonu, ako je znázornené na obrázku 2(b). Táto metóda výrazne zvyšuje hustotu kroku a zároveň znižuje veľkosť kroku, uľahčuje nukleáciu predovšetkým v miestach krokového zhluku, a tak umožňuje epitaxnej vrstve dokonale replikovať sekvenciu stohovania substrátu, čím sa eliminuje koexistencia polytypov.
Obrázok 2: Ukazuje fyzikálny proces krokovo riadenej epitaxie v 4H-SiC.
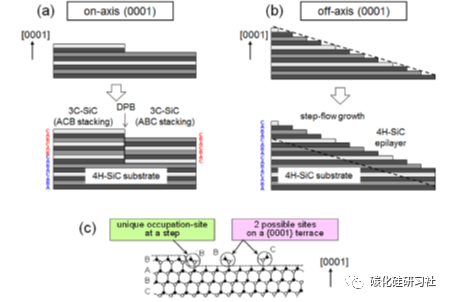
Obrázok 3: Ukazuje kritické podmienky pre rast CVD v stupňovito riadenej epitaxii pre 4H-SiC.

Obrázok 4: Porovnáva rýchlosti rastu pod rôznymi zdrojmi kremíka pre 4H-SiC epitaxiu.

V oblasti nízkonapäťových a strednonapäťových aplikácií (napr. 1200V zariadenia) dosiahla technológia epitaxie SiC zrelú fázu, ktorá ponúka relatívne vynikajúcu jednotnosť v hrúbke, koncentrácii dopingu a distribúcii defektov, čo primerane spĺňa požiadavky na nízkonapäťové a strednonapäťové SBD. , zariadenia MOS, JBS a iné.
Oblasť vysokého napätia však stále predstavuje významné výzvy. Napríklad zariadenia dimenzované na 10 000 V vyžadujú epitaxné vrstvy s hrúbkou približne 100 μm, ale tieto vrstvy vykazujú podstatne horšiu hrúbku a rovnomernosť dopingu v porovnaní s ich nízkonapäťovými náprotivkami, nehovoriac o škodlivom vplyve trojuholníkových defektov na celkový výkon zariadenia. Vysokonapäťové aplikácie, ktoré majú tendenciu uprednostňovať bipolárne zariadenia, tiež kladú prísne požiadavky na životnosť minoritných nosičov, čo si vyžaduje optimalizáciu procesu na zlepšenie tohto parametra.
V súčasnosti na trhu dominujú 4-palcové a 6-palcové epitaxné doštičky SiC s postupným zvyšovaním podielu epitaxných doštičiek SiC s veľkým priemerom. Veľkosť epitaxných plátkov SiC je zásadne určená rozmermi substrátov SiC. So 6-palcovými SiC substrátmi, ktoré sú teraz komerčne dostupné, prechod zo 4-palcovej na 6-palcovú SiC epitaxiu neustále prebieha.
Ako napreduje technológia výroby substrátu SiC a rozširujú sa výrobné kapacity, náklady na substráty SiC postupne klesajú. Vzhľadom na to, že substráty predstavujú viac ako 50 % nákladov na epitaxné doštičky, očakáva sa, že klesajúce ceny substrátov povedú k nižším nákladom na epitaxiu SiC, čím sa odvetviu sľubuje lepšia budúcnosť.**




