
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dosiahnutie vysokokvalitného rastu kryštálov SiC prostredníctvom riadenia teplotného gradientu v počiatočnej fáze rastu
Úvod
Karbid kremíka (SiC) je širokopásmový polovodičový materiál, ktorý si v posledných rokoch získal značnú pozornosť vďaka svojmu výnimočnému výkonu vo vysokonapäťových a vysokoteplotných aplikáciách. Rýchly pokrok v metódach fyzického transportu pár (PVT) nielen zlepšil kvalitu monokryštálov SiC, ale tiež úspešne dosiahol výrobu 150 mm monokryštálov SiC. Avšak, kvalitaSiC doštičkystále vyžaduje ďalšie zlepšenie, najmä pokiaľ ide o zníženie hustoty defektov. Je dobre známe, že v pestovaných kryštáloch SiC existujú rôzne defekty, predovšetkým kvôli nedostatočnému pochopeniu mechanizmov tvorby defektov počas procesu rastu kryštálov SiC. Ďalší hĺbkový výskum procesu rastu PVT je potrebný na zvýšenie priemeru a dĺžky kryštálov SiC a zároveň na zvýšenie rýchlosti kryštalizácie, čím sa urýchli komercializácia zariadení na báze SiC. Na dosiahnutie vysoko kvalitného rastu kryštálov SiC sme sa zamerali na kontrolu teplotného gradientu počas počiatočnej fázy rastu. Pretože plyny bohaté na kremík (Si, Si2C) môžu poškodiť povrch očkovacích kryštálov počas počiatočnej fázy rastu, stanovili sme v počiatočnom štádiu rôzne teplotné gradienty a upravili sme na konštantné teplotné podmienky pomeru C/Si počas hlavného procesu rastu. Táto štúdia systematicky skúma rôzne charakteristiky kryštálov SiC pestovaných s použitím modifikovaných procesných podmienok.
Experimentálne metódy
Rast 6-palcových 4H-SiC guľôčok sa uskutočňoval pomocou metódy PVT na 4° substrátoch C-face mimo osi. Boli navrhnuté zlepšené podmienky procesu pre počiatočnú fázu rastu. Teplota rastu bola nastavená medzi 2300-2400 °C a tlak bol udržiavaný na 5-20 Torr v prostredí dusíka a argónu. 6-palcový4H-SiC doštičkyboli vyrobené štandardnými technikami spracovania polovodičov. TheSiC doštičkyboli spracované podľa rôznych podmienok teplotného gradientu v počiatočnej fáze rastu a leptané pri 600 °C počas 14 minút na vyhodnotenie defektov. Hustota jamiek leptania (EPD) povrchu sa merala pomocou optického mikroskopu (OM). Hodnoty plnej šírky pri polovičnom maxime (FWHM) a mapovacie obrázky6-palcové doštičky SiCboli merané pomocou systému rôntgenovej difrakcie s vysokým rozlíšením (XRD).
Výsledky a diskusia

Obrázok 1: Schéma mechanizmu rastu kryštálov SiC
Na dosiahnutie vysoko kvalitného rastu monokryštálov SiC je zvyčajne potrebné používať zdroje práškov SiC s vysokou čistotou, presne kontrolovať pomer C/Si a udržiavať konštantnú rastovú teplotu a tlak. Okrem toho je rozhodujúca minimalizácia straty očkovacích kryštálov a potlačenie tvorby povrchových defektov na očkovacích kryštáloch počas počiatočnej fázy rastu. Obrázok 1 ilustruje schému mechanizmu rastu kryštálov SiC v tejto štúdii. Ako je znázornené na obrázku 1, plynné pary (ST) sú transportované na povrch zárodočného kryštálu, kde difundujú a tvoria kryštál. Niektoré plyny, ktoré sa nezúčastňujú rastu (ST), sa desorbujú z povrchu kryštálu. Keď množstvo plynu na povrchu zárodočného kryštálu (SG) presiahne desorbovaný plyn (SD), proces rastu pokračuje. Preto bol vhodný pomer plynu (SG) / plynu (SD) počas procesu rastu študovaný zmenou polohy RF vykurovacej cievky.
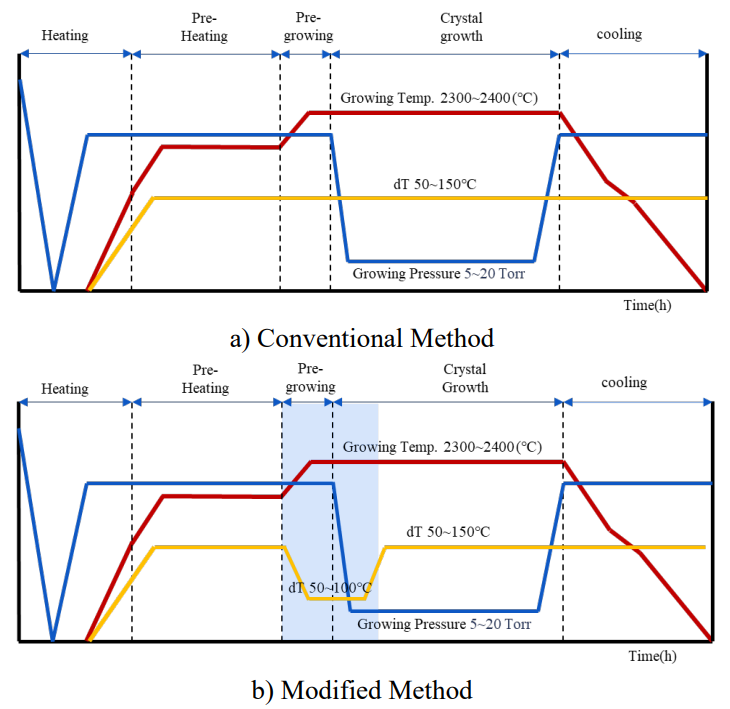
Obrázok 2: Schéma podmienok procesu rastu kryštálov SiC
Obrázok 2 ukazuje schému podmienok procesu rastu kryštálov SiC v tejto štúdii. Typická teplota procesu rastu sa pohybuje od 2300 do 2400 °C, s tlakom udržiavaným na 5 až 20 Torr. Počas procesu rastu sa teplotný gradient udržiava na dT=50~150°C ((a) konvenčná metóda). Niekedy môže nerovnomerné zásobovanie zdrojovými plynmi (Si2C, SiC2, Si) viesť k poruchám vo vrstvení, polytypovým inklúziám a tým k zhoršeniu kvality kryštálov. Preto sa v počiatočnej fáze rastu, zmenou polohy RF cievky, dT starostlivo kontroloval v rámci 50 ~ 100 ° C, potom sa upravil na dT = 50 ~ 150 ° C počas hlavného procesu rastu ((b) vylepšená metóda) . Na kontrolu teplotného gradientu (dT[°C] = Tbottom-Tupper) bola spodná teplota fixovaná na 2300 °C a horná teplota bola upravená z 2270 °C, 2250 °C, 2200 °C na 2150 °C. Tabuľka 1 uvádza snímky z optického mikroskopu (OM) povrchu guličiek SiC pestovaných za rôznych podmienok teplotného gradientu po 10 hodinách.
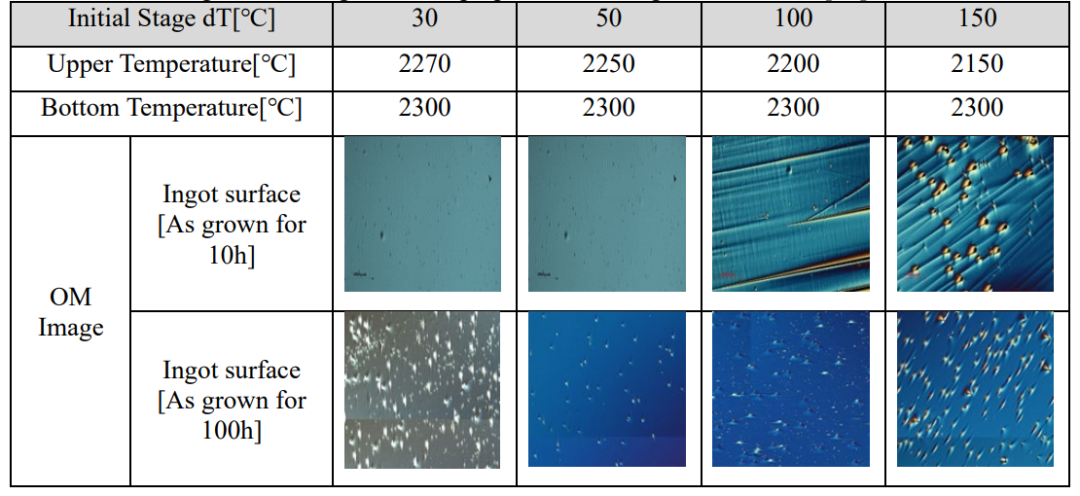
Tabuľka 1: Obrázky z optického mikroskopu (OM) povrchu SiC Boule pestovaného počas 10 hodín a 100 hodín pri rôznych podmienkach gradientu teploty
Pri počiatočnej dT = 50 ° C bola hustota defektov na povrchu guličiek SiC po 10 hodinách rastu výrazne nižšia ako pri dT = 30 ° C a dT = 150 ° C. Pri dT = 30 °C môže byť počiatočný teplotný gradient príliš malý, čo vedie k strate zárodočných kryštálov a tvorbe defektov. Naopak, pri vyššom počiatočnom teplotnom gradiente (dT=150°C) môže dôjsť k nestabilnému stavu presýtenia, čo vedie k polytypovým inklúziám a defektom v dôsledku vysokých koncentrácií vakancií. Ak je však počiatočný teplotný gradient optimalizovaný, je možné dosiahnuť kvalitný rast kryštálov minimalizovaním tvorby počiatočných defektov. Pretože hustota defektov na povrchu guličiek SiC po 100 hodinách rastu bola podobná výsledkom po 10 hodinách, kritickým krokom pri získavaní vysoko kvalitných kryštálov SiC je zníženie tvorby defektov počas počiatočnej fázy rastu.
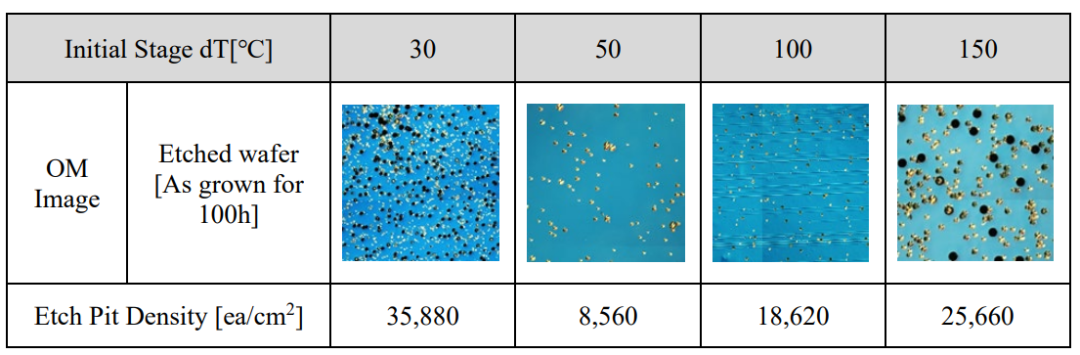
Tabuľka 2: Hodnoty EPD leptaných guľôčok SiC pri rôznych podmienkach gradientu teploty
Oblátkypripravené z guličiek pestovaných počas 100 hodín boli leptané, aby sa študovala hustota defektov kryštálov SiC, ako je uvedené v tabuľke 2. Hodnoty EPD kryštálov SiC pestovaných pri počiatočnej teplote dT=30 °C a dT=150 °C boli 35 880/cm² a 25 660 /cm2, zatiaľ čo hodnota EPD kryštálov SiC pestovaných za optimalizovaných podmienok (dT=50°C) sa výrazne znížila na 8560/cm2.
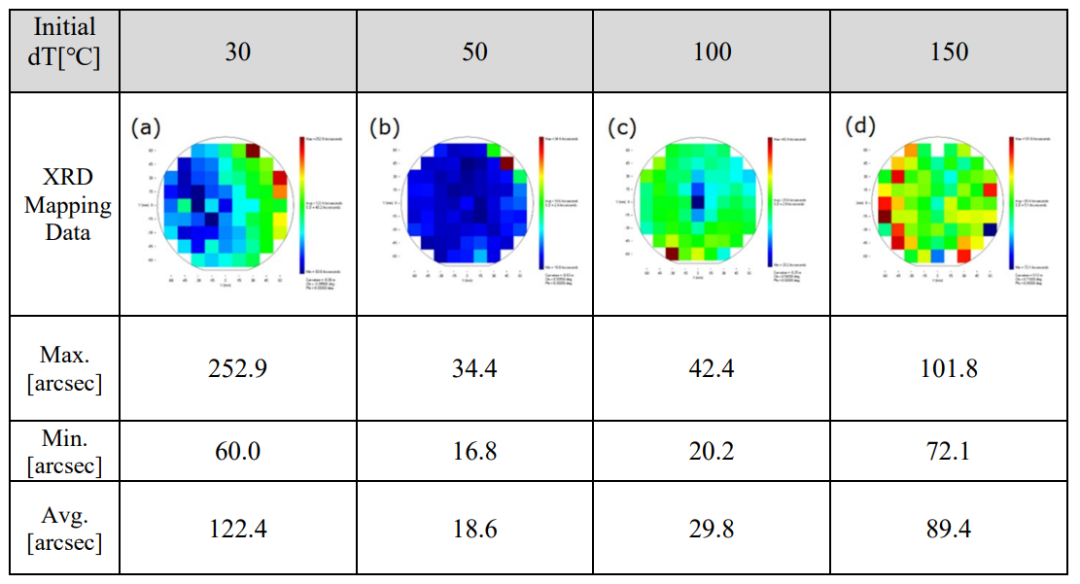
Tabuľka 3: Hodnoty FWHM a snímky XRD mapovania kryštálov SiC pri rôznych podmienkach gradientu počiatočnej teploty
Tabuľka 3 uvádza hodnoty FWHM a XRD mapovanie kryštálov SiC pestovaných za rôznych podmienok počiatočného teplotného gradientu. Priemerná hodnota FWHM kryštálov SiC pestovaných za optimalizovaných podmienok (dT=50 °C) bola 18,6 oblúkových sekúnd, čo je výrazne nižšia hodnota ako u kryštálov SiC pestovaných za iných podmienok teplotného gradientu.
Záver
Vplyv teplotného gradientu počiatočnej rastovej fázy na kvalitu kryštálov SiC bol študovaný riadením teplotného gradientu (dT[°C] = Tbottom-Tupper) zmenou polohy cievky. Výsledky ukázali, že hustota defektov na povrchu guličiek SiC po 10 hodinách rastu za počiatočných podmienok dT=50 °C bola významne nižšia ako hustota pri dT=30 °C a dT=150 °C. Priemerná hodnota FWHM kryštálov SiC pestovaných za optimalizovaných podmienok (dT=50 °C) bola 18,6 oblúkových sekúnd, čo je výrazne nižšia hodnota ako pri kryštáloch SiC pestovaných za iných podmienok. To naznačuje, že optimalizácia počiatočného teplotného gradientu účinne znižuje tvorbu počiatočných defektov, čím sa dosahuje vysokokvalitný rast kryštálov SiC.**




