
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Plazmové procesy v CVD operáciách
1. Čistenie komory
Počas procesu chemickej depozície z plynnej fázy (CVD) sa usadeniny tvoria nielen na povrchu plátku, ale aj na komponentoch v procesnej komore a jej stenách. Filmy nanesené na častiach sa musia pravidelne odstraňovať, aby sa zachovali stabilné podmienky procesu a zabránilo sa kontaminácii doštičiek časticami. Väčšina komôr CVD využíva na čistenie chemické reakčné plyny na báze fluóru.
V CVD komorách s oxidom kremičitým plazmové čistenie zvyčajne zahŕňa fluórované uhľovodíkové plyny, ako sú CF4, C2F6 a C3F8, ktoré sa v plazme rozkladajú a uvoľňujú fluórové radikály. Chemické reakcie sú znázornené nasledovne:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Atómy fluóru, ktoré patria medzi najreaktívnejšie radikály, rýchlo reagujú s oxidom kremičitým za vzniku plynného SiF4, ktorý sa dá ľahko evakuovať z komory:
·F + SiO2 -> SiF4 + O2 + iné prchavé vedľajšie produkty
Volfrámové CVD komory zvyčajne používajú SF6 a NF3 ako zdroje fluóru. Fluórové radikály reagujú s volfrámom za vzniku prchavého hexafluoridu volfrámového (WF6), ktorý je možné evakuovať z komory pomocou vákuových čerpadiel. Čistenie plazmovej komory môže byť automaticky ukončené monitorovaním emisných charakteristík fluóru v plazme, čím sa zabráni nadmernému čisteniu komory. Tieto aspekty budú diskutované podrobnejšie.
2. Výplň medzery
Keď sa medzera medzi kovovými čiarami zúži na 0,25 µm s pomerom strán 4:1, väčšina techník nanášania CVD má problém vyplniť medzery bez dutín. Vysokohustotné plazmové CVD (HDP-CVD) je schopné vyplniť takéto úzke medzery bez vytvárania dutín (pozri obrázok nižšie). Proces HDP-CVD bude opísaný neskôr.
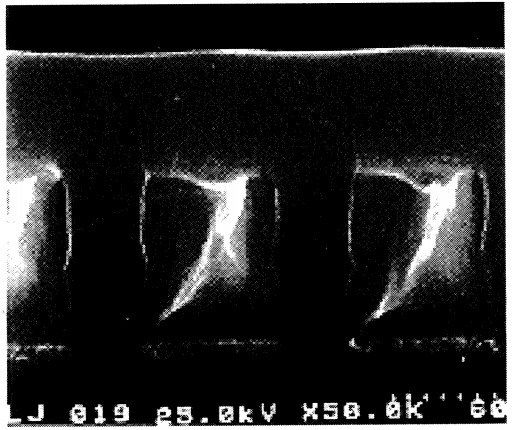
3. Plazmové leptanie
V porovnaní s mokrým leptaním ponúka plazmové leptanie výhody, ako sú profily anizotropného leptania, automatická detekcia koncového bodu a nižšia spotreba chemikálií spolu s primerane vysokými rýchlosťami leptania, dobrou selektivitou a jednotnosťou.
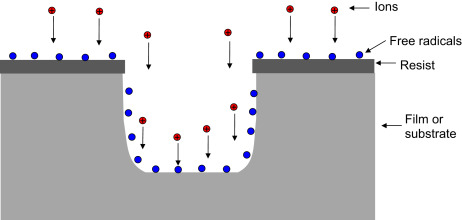
4. Kontrola profilov Etch
Predtým, ako sa plazmové leptanie stalo rozšíreným vo výrobe polovodičov, väčšina výrobcov plátkov používala mokré chemické leptanie na prenos vzorov. Mokré leptanie je však izotropný proces (leptanie rovnakou rýchlosťou v každom smere). Keď sa veľkosť prvkov zmenší pod 3 µm, izotropné leptanie vedie k podrezaniu, čo obmedzuje aplikáciu mokrého leptania.
Pri plazmových procesoch ióny neustále bombardujú povrch plátku. Či už prostredníctvom mechanizmov poškodenia mriežky alebo mechanizmov pasivácie bočných stien, plazmové leptanie môže dosiahnuť anizotropné profily leptania. Znížením tlaku počas procesu leptania sa môže zvýšiť stredná voľná dráha iónov, čím sa znížia kolízie iónov pre lepšiu kontrolu profilu.
5. Rýchlosť leptania a selektivita
Iónové bombardovanie v plazme pomáha rozbiť chemické väzby povrchových atómov a vystaviť ich radikálom generovaným plazmou. Táto kombinácia fyzikálneho a chemického spracovania výrazne zvyšuje rýchlosť chemickej reakcie leptania. Rýchlosť leptania a selektivita sú diktované požiadavkami procesu. Keďže iónové bombardovanie aj radikály zohrávajú kľúčovú úlohu pri leptaní a RF výkon môže kontrolovať iónové bombardovanie a radikály, RF výkon sa stáva kľúčovým parametrom pre riadenie rýchlosti leptania. Zvýšenie vysokofrekvenčného výkonu môže výrazne zvýšiť rýchlosť leptania, čo bude diskutované podrobnejšie, čo tiež ovplyvňuje selektivitu.
6. Detekcia koncového bodu
Bez plazmy musí byť konečný bod leptania určený časom alebo vizuálnou kontrolou operátora. V plazmových procesoch, keď leptanie postupuje cez povrchový materiál, aby začalo leptať podkladový (koncový) materiál, chemické zloženie plazmy sa mení v dôsledku zmeny vo vedľajších produktoch leptania, čo je zrejmé prostredníctvom zmeny farby emisie. Monitorovaním zmeny farby emisie pomocou optických senzorov je možné automaticky spracovať koncový bod leptania. Pri výrobe IC je to veľmi cenný nástroj.**




