
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Pochopenie celého procesu výroby polovodičových zariadení
1. Fotolitografia
Fotolitografia, často synonymum pre generovanie vzorov, je jednou z najdôležitejších hnacích síl rýchleho rozvoja polovodičovej technológie, ktorá pochádza z procesov výroby fotografických platní v tlači. Táto technika umožňuje prezentáciu akéhokoľvek vzoru na mikro alebo nano mierke pomocou fotorezist a v kombinácii s inými procesnými technológiami prenáša tieto vzory na materiály, čím sa realizujú rôzne návrhy a koncepcie polovodičových materiálov a zariadení. Svetelný zdroj používaný vo fotolitografii priamo ovplyvňuje presnosť vzorov s možnosťami od ultrafialového, hlbokého ultrafialového až po röntgenové lúče a elektrónové lúče, z ktorých každý zodpovedá zvyšujúcej sa úrovni vernosti vzoru v uvedenom poradí.
Štandardný proces fotolitografie zahŕňa prípravu povrchu, adhéziu, mäkké vypaľovanie, expozíciu, postexpozičné vypaľovanie, vyvolávanie, tvrdé vypaľovanie a kontrolu.
Povrchová úprava je nevyhnutná, pretože substráty typicky absorbujú molekuly H2O zo vzduchu, čo je škodlivé pre fotolitografiu. Preto substráty najprv podliehajú dehydratačnému spracovaniu pomocou pečenia.
V prípade hydrofilných substrátov je ich adhézia k hydrofóbnemu fotorezistu nedostatočná, čo môže spôsobiť oddelenie fotorezistu alebo nesprávne zarovnanie vzoru, a teda potrebu promótora adhézie. V súčasnosti sú hexametyldisilazan (HMDS) a tri-metyl-silyl-dietyl-amín (TMSDEA) široko používanými zosilňovačmi adhézie.
Po povrchovej úprave začína aplikácia fotorezistu. Hrúbka naneseného fotorezistu nesúvisí len s jeho viskozitou, ale je ovplyvnená aj rýchlosťou odstreďovania, ktorá je vo všeobecnosti nepriamo úmerná druhej odmocnine rýchlosti odstreďovania. Po potiahnutí sa vykoná mäkké vypaľovanie, aby sa odparilo rozpúšťadlo z fotorezistu, čím sa zlepšila priľnavosť v procese známom ako predpekanie.
Po dokončení týchto krokov dôjde k expozícii. Fotorezisty sú klasifikované ako pozitívne alebo negatívne, s opačnými vlastnosťami po expozícii.
Zoberme si pozitívny fotorezist ako príklad, kde neexponovaný fotorezist je nerozpustný vo vývojke, ale po expozícii sa stáva rozpustným. Počas expozície svetelný zdroj prechádzajúci cez vzorovanú masku osvetľuje potiahnutý substrát a vytvára vzor na fotoreziste. Typicky musí byť substrát pred expozíciou zarovnaný s maskou, aby sa presne kontrolovala poloha expozície. Trvanie expozície sa musí prísne riadiť, aby sa zabránilo skresleniu vzoru. Po expozícii môže byť potrebné ďalšie pečenie na zmiernenie efektov stojatých vĺn, hoci tento krok je voliteľný a možno ho obísť v prospech priameho vývoja. Vyvolanie rozpúšťa exponovaný fotorezist a presne prenáša vzor masky na vrstvu fotorezistu. Čas vývoja je tiež kritický – príliš krátky vedie k neúplnému vývoju, príliš dlhý spôsobuje skreslenie vzoru.
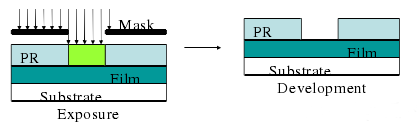
Následne tvrdé vypaľovanie posilňuje priľnavosť filmu fotorezistu k substrátu a zlepšuje jeho odolnosť voči leptaniu. Teplota tvrdého pečenia je vo všeobecnosti o niečo vyššia ako teplota predpečenia.
Nakoniec mikroskopická kontrola overí, či vzor zodpovedá očakávaniam. Po prenesení vzoru na materiál inými procesmi fotorezist splnil svoj účel a musí sa odstrániť. Metódy odstraňovania zahŕňajú mokré (použitie silných organických rozpúšťadiel, ako je acetón) a suché (použitie kyslíkovej plazmy na odleptanie filmu).
2. Dopingové techniky
Doping je nevyhnutný v polovodičovej technológii, ktorá podľa potreby mení elektrické vlastnosti polovodičových materiálov. Medzi bežné dopingové metódy patrí tepelná difúzia a implantácia iónov.
(1) Iónová implantácia
Iónová implantácia dopuje polovodičový substrát bombardovaním vysokoenergetickými iónmi. V porovnaní s tepelnou difúziou má mnoho výhod. Ióny vybrané hmotnostným analyzátorom zaisťujú vysokú dopingovú čistotu. Počas implantácie zostáva substrát pri izbovej teplote alebo mierne vyššej. Môže sa použiť veľa maskovacích fólií, ako je oxid kremičitý (SiO2), nitrid kremíka (Si3N4) a fotorezist, ktoré poskytujú vysokú flexibilitu s technikami samonastavovacej masky. Dávky implantátov sú presne kontrolované a distribúcia iónov implantovaných nečistôt je rovnomerná v rovnakej rovine, čo vedie k vysokej opakovateľnosti.
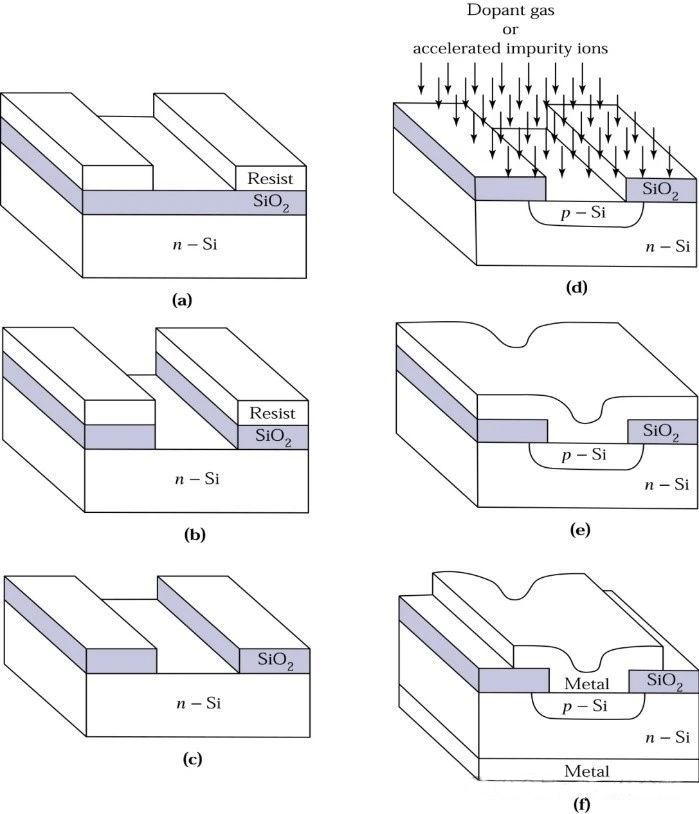
Hĺbka implantácie je určená energiou iónov. Reguláciou energie a dávky možno manipulovať s distribúciou iónov nečistôt v substráte po implantácii. Viacnásobné implantácie s rôznymi schémami sa môžu vykonávať nepretržite, aby sa dosiahli rôzne profily nečistôt. Je pozoruhodné, že v monokryštálových substrátoch, ak je smer implantácie rovnobežný s kryštalografickým smerom, dochádza k kanálovým efektom - niektoré ióny sa budú pohybovať pozdĺž kanálov, čo sťažuje kontrolu hĺbky.
Aby sa zabránilo kanálovaniu, implantácia sa typicky uskutočňuje pod uhlom približne 7° k hlavnej osi monokryštálového substrátu alebo pokrytím substrátu amorfnou vrstvou.
Implantácia iónov však môže výrazne poškodiť kryštálovú štruktúru substrátu. Vysokoenergetické ióny pri zrážke prenášajú energiu do jadier a elektrónov substrátu, čo spôsobuje, že opúšťajú mriežku a vytvárajú páry defektov medzi intersticiálnou vakanciou. V závažných prípadoch môže byť kryštálová štruktúra v niektorých oblastiach zničená, čím sa vytvoria amorfné zóny.
Poškodenie mriežky výrazne ovplyvňuje elektrické vlastnosti polovodičového materiálu, ako je zníženie mobility nosiča alebo životnosť nerovnovážnych nosičov. Najdôležitejšie je, že väčšina implantovaných nečistôt zaberá nepravidelné intersticiálne miesta a nedokáže vytvoriť účinný doping. Preto je nevyhnutná oprava poškodenia mriežky po implantácii a elektrická aktivácia nečistôt.
(2)Rýchle tepelné spracovanie (RTP)
Tepelné žíhanie je najúčinnejšou metódou na úpravu poškodenia mriežky spôsobeného implantáciou iónov a elektricky aktivujúcich nečistôt. Pri vysokých teplotách sa páry defektov intersticiálna vakancia v kryštálovej mriežke substrátu rekombinujú a zmiznú; amorfné oblasti budú tiež rekryštalizovať z hranice s monokryštálovými oblasťami prostredníctvom epitaxie v pevnej fáze. Aby sa zabránilo oxidácii materiálu substrátu pri vysokých teplotách, musí sa tepelné žíhanie vykonávať vo vákuu alebo v atmosfére inertného plynu. Tradičné žíhanie trvá dlho a môže spôsobiť značné prerozdelenie nečistôt v dôsledku difúzie.
PríchodRTP technológiarieši tento problém a do značnej miery dosahuje opravu poškodenia mriežky a aktiváciu nečistôt v rámci skráteného trvania žíhania.
V závislosti od zdroja tepla,RTPsa kategorizuje do niekoľkých typov: skenovanie elektrónovým lúčom, pulzné elektrónové a iónové lúče, pulzné lasery, lasery s kontinuálnou vlnou a širokopásmové nekoherentné svetelné zdroje (halogénové výbojky, grafitové ohrievače, oblúkové výbojky), pričom posledné menované sú najpoužívanejšie. Tieto zdroje dokážu zahriať substrát na požadovanú teplotu v okamihu, čím v krátkom čase dokončí žíhanie a efektívne znížia difúziu nečistôt.
3. Techniky nanášania filmu
(1) Plazma-Enhanced Chemical Vap Deposition (PECVD)
PECVD je jedna z foriem chemickej depozície z plynnej fázy (CVD) na nanášanie filmu, pričom ďalšie dve sú CVD pri atmosférickom tlaku (APCVD) a CVD pri nízkom tlaku (LPCVD).
V súčasnosti je PECVD najrozšírenejší spomedzi týchto troch typov. Využíva rádiofrekvenčnú (RF) plazmu na spustenie a udržiavanie chemických reakcií pri relatívne nízkych teplotách, čím uľahčuje nanášanie filmu pri nízkych teplotách s vysokými rýchlosťami nanášania. Schéma jeho vybavenia je znázornená.
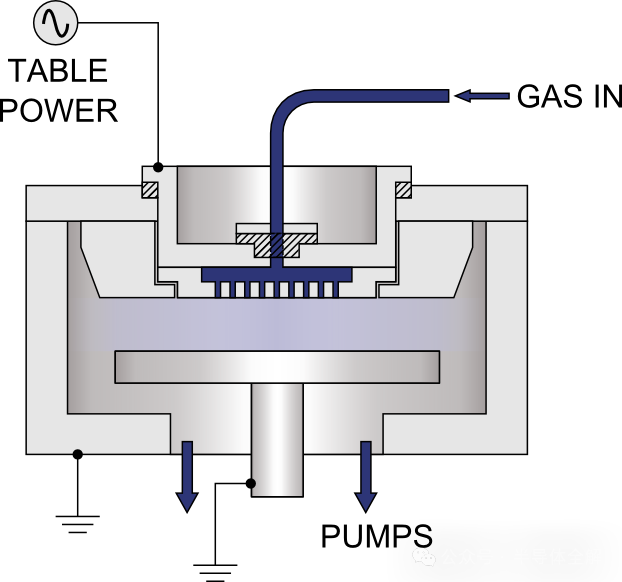
Filmy vyrobené týmto spôsobom vykazujú výnimočnú priľnavosť a elektrické vlastnosti, minimálnu mikroporéznosť, vysokú rovnomernosť a robustné možnosti plnenia v malom meradle. Faktory ovplyvňujúce kvalitu depozície PECVD zahŕňajú teplotu substrátu, prietok plynu, tlak, RF výkon a frekvenciu.
(2) Naprašovanie
Naprašovanie je metóda fyzikálneho nanášania pár (PVD). Nabité ióny (zvyčajne argónové ióny, Ar+) sa urýchľujú v elektrickom poli a získavajú kinetickú energiu. Sú nasmerované na cieľový materiál, narážajú na cieľové molekuly a spôsobujú ich uvoľnenie a rozprášenie. Tieto molekuly majú tiež významnú kinetickú energiu a pohybujú sa smerom k substrátu a ukladajú sa na ňom.

Typicky používané zdroje energie na naprašovanie zahŕňajú jednosmerný prúd (DC) a rádiovú frekvenciu (RF), kde jednosmerné naprašovanie je priamo aplikovateľné na vodivé materiály, ako sú kovy, zatiaľ čo izolačné materiály vyžadujú na nanášanie filmu vysokofrekvenčné naprašovanie.
Konvenčné naprašovanie trpí nízkou rýchlosťou nanášania a vysokým pracovným tlakom, čo vedie k nižšej kvalite filmu. Magnetrónové naprašovanie rieši tieto problémy ideálnejšie. Využíva vonkajšie magnetické pole na zmenu lineárnej trajektórie iónov na špirálovitú dráhu okolo smeru magnetického poľa, čím sa predlžuje ich dráha a zlepšuje sa účinnosť kolízie s cieľovými molekulami, čím sa zvyšuje účinnosť rozprašovania. To má za následok zvýšenie rýchlosti nanášania, zníženie pracovného tlaku a výrazne zlepšenú kvalitu filmu.
4. Leptanie Techniky
Leptanie je rozdelené do suchých a mokrých režimov, ktoré sú pomenované podľa použitia (alebo nedostatku) špecifických riešení.
Leptanie zvyčajne vyžaduje prípravu maskovej vrstvy (ktorá môže byť priamo fotorezistentná) na ochranu oblastí, ktoré nie sú určené na leptanie.
(1) Suché leptanie
Bežné typy suchého leptania zahŕňajúLeptanie indukčne viazanou plazmou (ICP).leptanie iónovým lúčom (IBE) a reaktívne iónové leptanie (RIE).
Pri ICP leptaní plazma produkovaná žeravým výbojom obsahuje množstvo vysoko chemicky aktívnych voľných radikálov (voľné atómy, molekuly alebo atómové skupiny), ktoré chemicky reagujú s cieľovým materiálom za vzniku prchavých produktov, čím sa dosiahne leptanie.
IBE využíva vysokoenergetické ióny (ionizované z inertných plynov) na priame bombardovanie povrchu cieľového materiálu na leptanie, čo predstavuje fyzikálny proces.
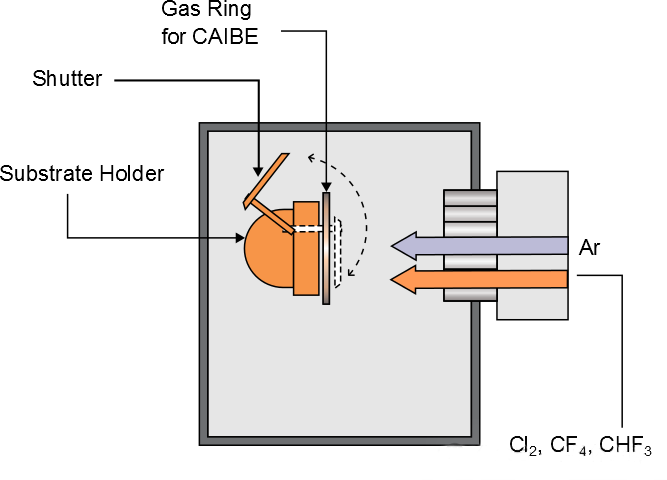
RIE sa považuje za kombináciu predchádzajúcich dvoch, ktorá nahrádza inertný plyn používaný v IBE plynom používaným pri ICP leptaní, čím sa vytvára RIE.
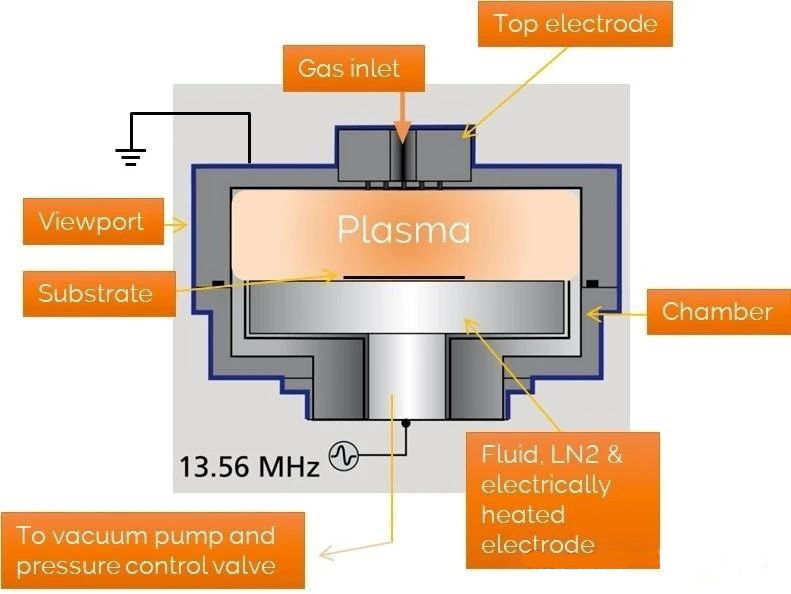
V prípade suchého leptania vertikálna rýchlosť leptania ďaleko presahuje laterálnu rýchlosť, t.j. má vysoký pomer strán, čo umožňuje presnú replikáciu vzoru masky. Suché leptanie však leptá aj vrstvu masky, čo vykazuje horšiu selektivitu (pomer rýchlosti leptania cieľového materiálu k vrstve masky), najmä pri IBE, ktorý môže neselektívne leptať na povrchu materiálu.
(2) Mokré leptanie
Mokré leptanie označuje spôsob leptania, ktorý sa dosiahne ponorením cieľového materiálu do roztoku (leptadla), ktorý s ním chemicky reaguje.
Táto metóda leptania je jednoduchá, nákladovo efektívna a vykazuje dobrú selektivitu, ale má nízky pomer strán. Materiál pod okrajmi masky môže byť skorodovaný, takže je menej presný ako suché leptanie. Na zmiernenie negatívnych dopadov nízkeho pomeru strán je potrebné zvoliť vhodné rýchlosti leptania. Faktory ovplyvňujúce rýchlosť leptania zahŕňajú koncentráciu leptadla, čas leptania a teplotu leptania.**




