
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Vysoká čistota CVD Hrubý SiC: Procesné pohľady na rast materiálu
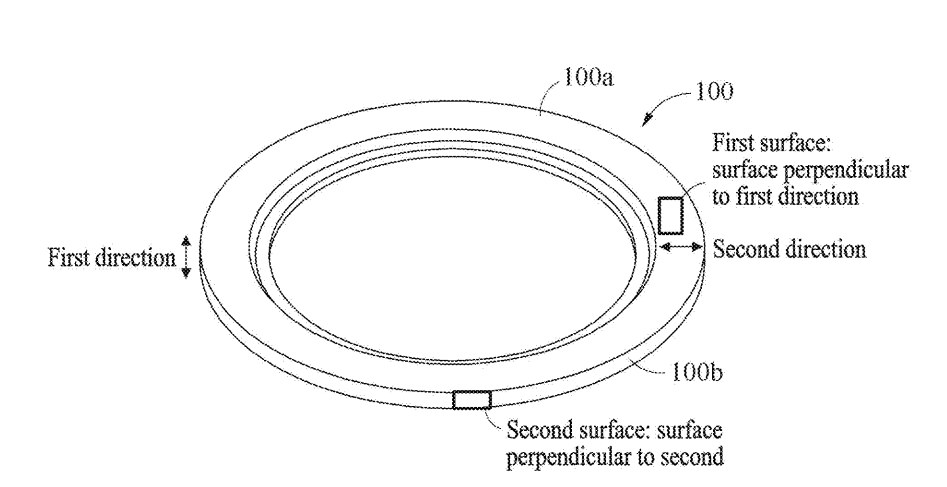
1. KonvenčnéCVD SiCProces ukladania
Štandardný proces CVD na nanášanie povlakov SiC zahŕňa sériu starostlivo kontrolovaných krokov:
Kúrenie:CVD pec sa zahrieva na teplotu medzi 100-160°C.
Nakladanie substrátu:Grafitový substrát (tŕň) je umiestnený na otočnej plošine v nanášacej komore.
Vysávanie a čistenie:Komora sa evakuuje a prepláchne plynným argónom (Ar) vo viacerých cykloch.
Regulácia kúrenia a tlaku:Komora sa zahrieva na depozičnú teplotu za nepretržitého vákua. Po dosiahnutí požadovanej teploty sa udržiava čas zdržania pred zavedením plynu Ar, aby sa dosiahol tlak 40-60 kPa. Komora sa potom opäť evakuuje.
Úvod prekurzorového plynu:Zmes vodíka (H2), argónu (Ar) a uhľovodíkového plynu (alkánu) sa zavádza do predhrievacej komory spolu s prekurzorom chlórsilánu (typicky chlorid kremičitý, SiCl4). Výsledná zmes plynov sa potom privádza do reakčnej komory.
Depozícia a chladenie:Po dokončení nanášania sa zastaví tok H2, chlórsilánu a alkánu. Prietok argónu sa udržiava na prečistenie komory počas chladenia. Nakoniec sa komora privedie na atmosférický tlak, otvorí sa a grafitový substrát potiahnutý SiC sa odstráni.
2. Aplikácie tlCVD SiCVrstvy
Vrstvy SiC s vysokou hustotou presahujúce hrúbku 1 mm nachádzajú kritické aplikácie v:
Výroba polovodičov:Ako zaostrovacie krúžky (FR) v systémoch suchého leptania na výrobu integrovaných obvodov.
Optika a letectvo:Vrstvy SiC s vysokou transparentnosťou sa používajú v optických zrkadlách a oknách kozmických lodí.
Tieto aplikácie vyžadujú vysokovýkonné materiály, vďaka ktorým je hrubý SiC produkt vysokej hodnoty s významným ekonomickým potenciálom.
3. Cieľové charakteristiky pre polovodičovú trieduCVD SiC
CVD SiCpre polovodičové aplikácie, najmä pre zaostrovacie krúžky, vyžaduje prísne materiálové vlastnosti:
Vysoká čistota:Polykryštalický SiC s úrovňou čistoty 99,9999 % (6N).
Vysoká hustota:Nevyhnutná je hustá mikroštruktúra bez pórov.
Vysoká tepelná vodivosť:Teoretické hodnoty sa približujú k 490 W/m·K, praktické hodnoty sa pohybujú v rozmedzí 200-400 W/m·K.
Riadený elektrický odpor:Žiaduce sú hodnoty medzi 0,01-500 Ω.cm.
Plazmatická odolnosť a chemická inertnosť:Rozhodujúce pre odolnosť voči agresívnemu leptanému prostrediu.
Vysoká tvrdosť:Vlastná tvrdosť SiC (~ 3000 kg/mm2) si vyžaduje špeciálne obrábacie techniky.
Kubická polykryštalická štruktúra:Je žiaduci prednostne orientovaný 3C-SiC (p-SiC) s dominantnou (111) kryštalografickou orientáciou.
4. Proces CVD pre 3C-SiC hrubé filmy
Preferovaný spôsob nanášania hrubých 3C-SiC filmov pre zaostrovacie krúžky je CVD s použitím nasledujúcich parametrov:
Výber prekurzora:Bežne sa používa metyltrichlórsilán (MTS), ktorý ponúka molárny pomer Si/C 1:1 pre stechiometrické nanášanie. Niektorí výrobcovia však optimalizujú pomer Si:C (1:1,1 až 1:1,4) na zvýšenie odolnosti voči plazme, čo môže mať vplyv na distribúciu veľkosti zŕn a preferovanú orientáciu.
Nosný plyn:Vodík (H2) reaguje s látkami obsahujúcimi chlór, zatiaľ čo argón (Ar) pôsobí ako nosný plyn pre MTS a riedi zmes plynov, čím riadi rýchlosť depozície.
5. Systém CVD pre aplikácie Focus Ring
Je prezentované schematické znázornenie typického CVD systému na nanášanie 3C-SiC pre zaostrovacie krúžky. Detailné výrobné systémy sú však často navrhnuté na mieru a vlastné.

6. Záver
Výroba vysoko čistých, hrubých SiC vrstiev pomocou CVD je zložitý proces vyžadujúci presnú kontrolu nad mnohými parametrami. Keďže dopyt po týchto vysokovýkonných materiáloch neustále rastie, prebiehajúce výskumné a vývojové snahy sa zameriavajú na optimalizáciu techník CVD, aby spĺňali prísne požiadavky výroby polovodičov novej generácie a iných náročných aplikácií.**




