
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe vo výrobe čipov: Profesionálna správa
Evolúcia polovodičových materiálov
V oblasti modernej polovodičovej technológie neúnavná snaha o miniaturizáciu posunula hranice tradičných materiálov na báze kremíka. Aby sa splnili požiadavky na vysoký výkon a nízku spotrebu energie, SiGe (Silicon Germanium) sa objavil ako kompozitný materiál voľby pri výrobe polovodičových čipov vďaka svojim jedinečným fyzikálnym a elektrickým vlastnostiam. Tento článok sa ponorí doproces epitaxieSiGe a jeho úloha pri epitaxnom raste, aplikáciách namáhaného kremíka a štruktúrach Gate-All-Around (GAA).
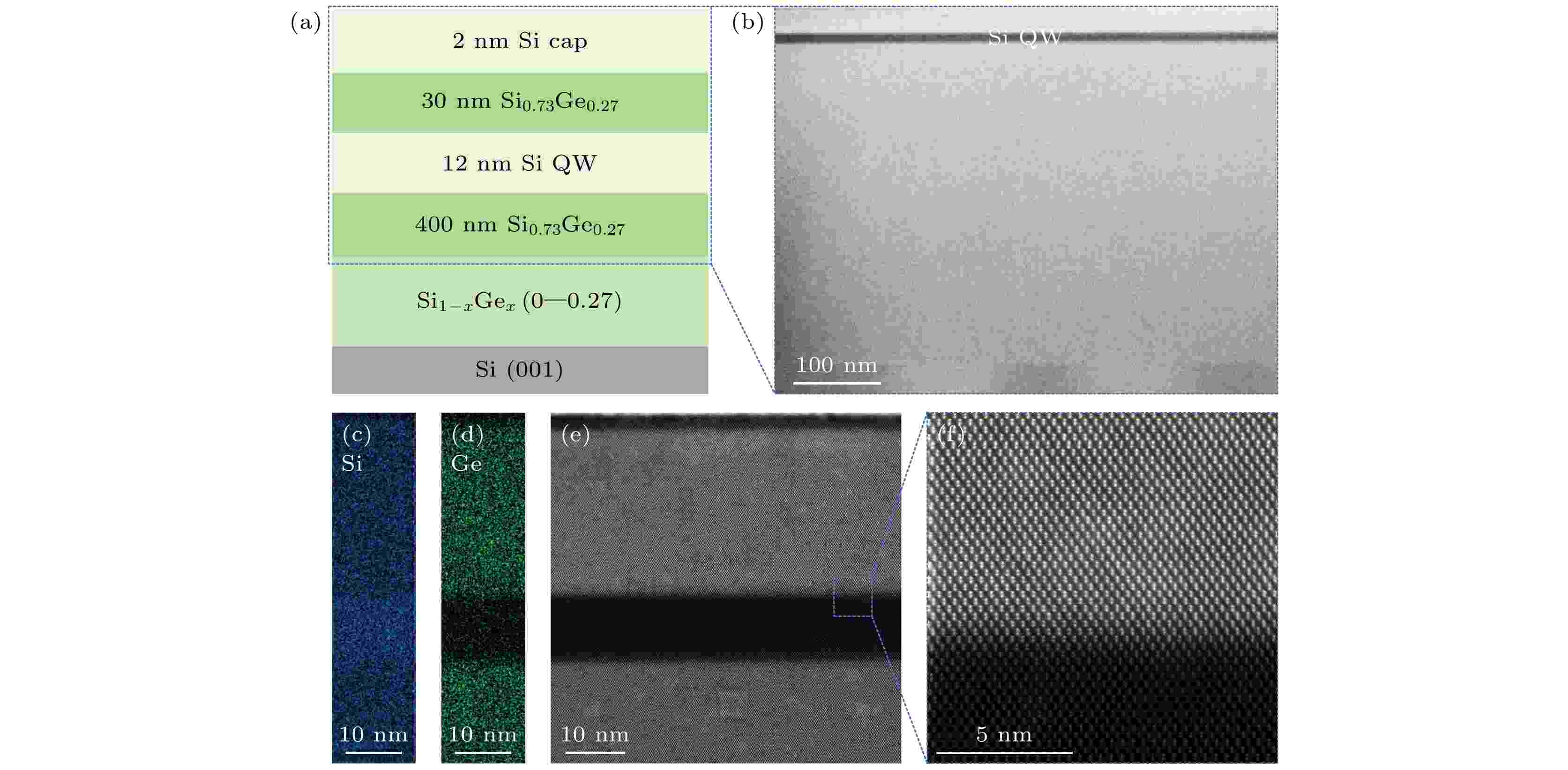
Význam SiGe epitaxie
1.1 Úvod do epitaxie vo výrobe čipov:
Epitaxia, často skracovaná ako Epi, označuje rast jednokryštálovej vrstvy na monokryštálovom substráte s rovnakým usporiadaním mriežky. Táto vrstva môže byť buďhomoepitaxné (ako Si/Si)alebo heteroepitaxiálne (ako je SiGe/Si alebo SiC/Si). Na epitaxný rast sa používajú rôzne metódy, vrátane epitaxie molekulárnym lúčom (MBE), ultravysokého vákuového chemického nanášania pár (UHV/CVD), atmosférickej epitaxie a epitaxie pri zníženom tlaku (ATM & RP Epi). Tento článok sa zameriava na procesy epitaxie kremíka (Si) a kremíka-germánia (SiGe), ktoré sa široko používajú pri výrobe polovodičových integrovaných obvodov s kremíkom ako substrátovým materiálom.
1.2 Výhody SiGe epitaxie:
Začlenenie určitého podielu germánia (Ge) počasproces epitaxievytvára SiGe monokryštálovú vrstvu, ktorá nielen zmenšuje šírku pásma, ale tiež zvyšuje medznú frekvenciu tranzistora (fT). Vďaka tomu je široko použiteľný vo vysokofrekvenčných zariadeniach pre bezdrôtovú a optickú komunikáciu. Okrem toho v pokročilých procesoch integrovaných obvodov CMOS nesúlad mriežky (približne 4 %) medzi Ge a Si zavádza napätie mriežky, čím sa zvyšuje pohyblivosť elektrónov alebo dier, a tým sa zvyšuje saturačný prúd zariadenia a rýchlosť odozvy.
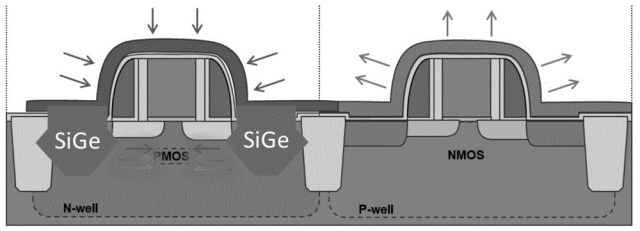
Komplexný tok procesu epitaxie SiGe
2.1 Predúprava:
Kremíkové doštičky sú predupravené na základe požadovaných výsledkov procesu, ktorý zahŕňa predovšetkým odstránenie prirodzenej oxidovej vrstvy a nečistôt na povrchu plátku. Pre silne dopované substrátové doštičky je dôležité zvážiť, či je spätné tesnenie potrebné na zníženie autodopingu počas nasledujúcichepitaxný rast.
2.2 Rastové plyny a podmienky:
Kremíkové plyny: Silán (SiH4), dichlórsilán (DCS, SiH2Cl2) a trichlórsilán (TCS, SiHCl3) sú tri najčastejšie používané zdroje kremíkového plynu. SiH₄ je vhodný pre nízkoteplotné úplné epitaxné procesy, zatiaľ čo TCS, známy svojou rýchlou rýchlosťou rastu, sa široko používa na prípravu hustýchsilikónová epitaxiavrstvy.
Germánium plyn: Germane (GeH₄) je primárnym zdrojom na pridávanie germánia, ktorý sa používa v spojení so zdrojmi kremíka na vytváranie zliatin SiGe.
Selektívna epitaxia: Selektívny rast sa dosiahne úpravou relatívnych rýchlostíepitaxná depozíciaa leptanie in situ s použitím plynného kremíka DCS s obsahom chlóru. Selektivita je spôsobená tým, že adsorpcia atómov Cl na povrchu kremíka je menšia ako na oxidoch alebo nitridoch, čo uľahčuje epitaxný rast. SiH4, ktorému chýbajú atómy Cl a má nízku aktivačnú energiu, sa vo všeobecnosti používa iba pri nízkoteplotných úplných epitaxných procesoch. Iný bežne používaný zdroj kremíka, TCS, má nízky tlak pár a je kvapalný pri teplote miestnosti, čo si vyžaduje prebublávanie H2 na jeho zavedenie do reakčnej komory. Je však relatívne lacný a často sa používa pre svoju rýchlu rýchlosť rastu (až 5 μm/min) na pestovanie hrubších kremíkových epitaxných vrstiev, ktoré sa široko používajú pri výrobe kremíkových epitaxných plátkov.
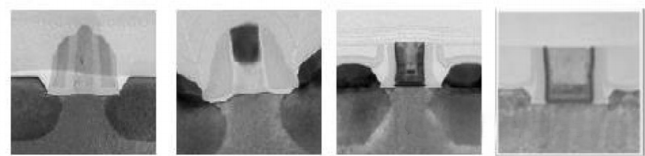
Napätý kremík v epitaxných vrstvách
Počasepitaxný rastsa epitaxný monokryštál Si ukladá na uvoľnenú vrstvu SiGe. V dôsledku nesúladu mriežky medzi Si a SiGe je monokryštálová vrstva Si vystavená ťahovému namáhaniu zo základnej SiGe vrstvy, čo výrazne zvyšuje mobilitu elektrónov v tranzistoroch NMOS. Táto technológia nielen zvyšuje saturačný prúd (Idsat), ale tiež zlepšuje rýchlosť odozvy zariadenia. V prípade zariadení PMOS sa vrstvy SiGe epitaxiálne pestujú v oblastiach zdroja a odtoku po leptaní, aby sa zaviedlo tlakové napätie na kanál, čím sa zvyšuje mobilita otvoru a zvyšuje sa saturačný prúd.
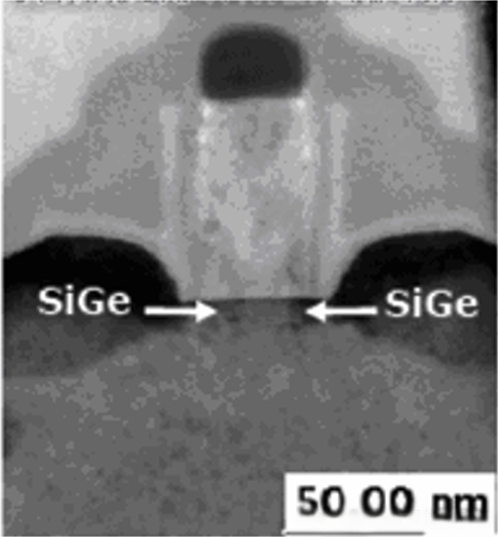
SiGe ako obetná vrstva v štruktúrach GAA
Pri výrobe nanovláknových tranzistorov Gate-All-Around (GAA) pôsobia SiGe vrstvy ako obetné vrstvy. Techniky anizotropného leptania s vysokou selektívnosťou, ako je kvázi-atómové leptanie (kvázi-ALE), umožňujú presné odstránenie vrstiev SiGe za vzniku nanovláknových alebo nanovrstvových štruktúr.
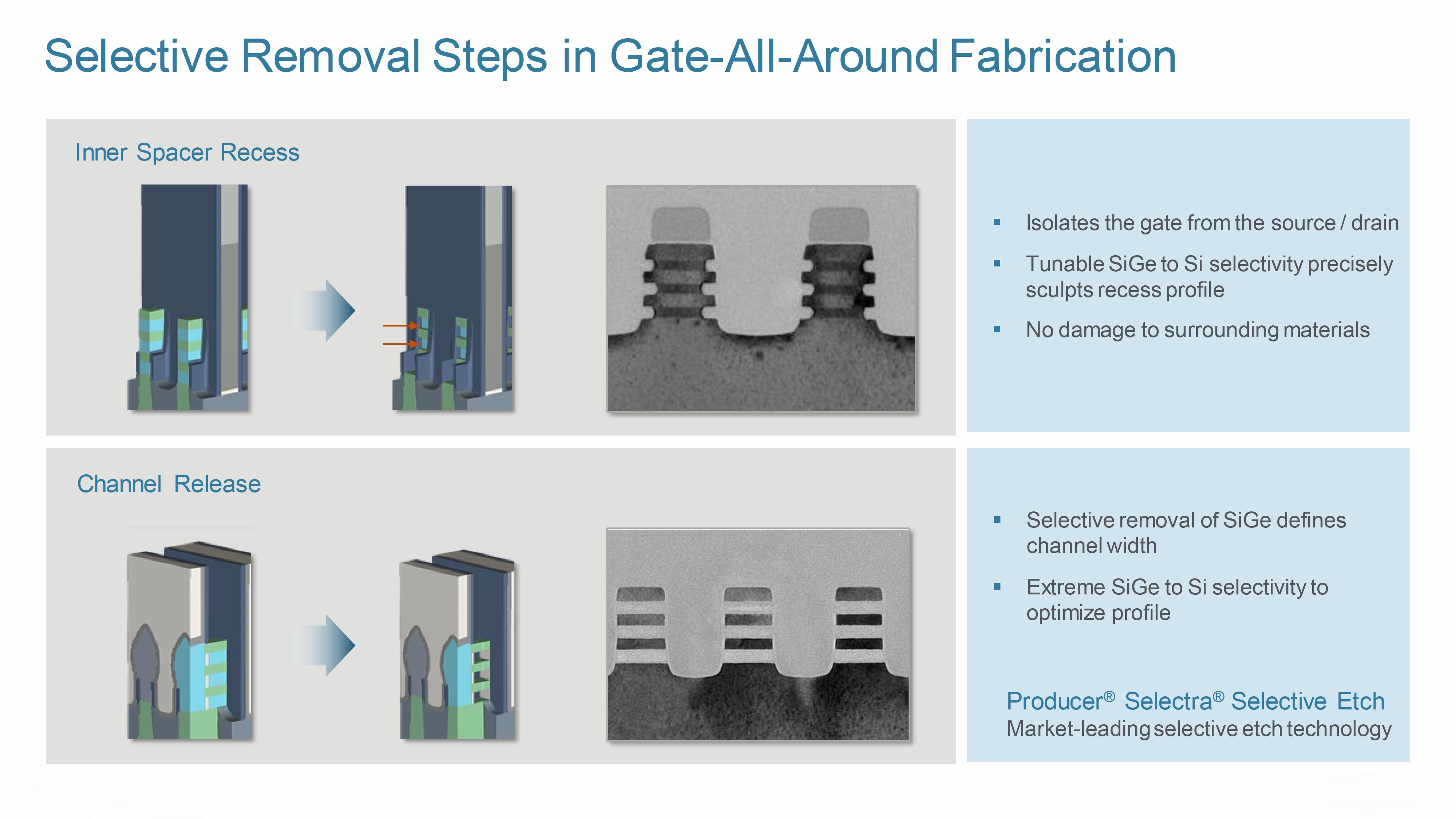
My v Semicorex sa špecializujeme naGrafitové roztoky potiahnuté SiC/TaCaplikované v epitaxnom raste Si pri výrobe polovodičov, ak máte akékoľvek otázky alebo potrebujete ďalšie podrobnosti, neváhajte nás kontaktovať.
Kontaktný telefón: +86-13567891907
E-mail: sales@semicorex.com




