
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe a Si selektívna technológia leptania
Gate-All-Around FET (GAAFET), ako tranzistorová architektúra novej generácie, ktorá má nahradiť FinFET, si získala značnú pozornosť pre svoju schopnosť poskytovať vynikajúce elektrostatické ovládanie a zvýšený výkon pri menších rozmeroch. Kritický krok pri výrobe GAAFET typu n zahŕňa vysokú selektivituleptanievrstiev SiGe:Si pred ukladaním vnútorných dištančných vložiek, vytváraním kremíkových nanovrstvov a uvoľňovaním kanálov.

Tento článok sa zaoberá výberomtechnológie leptaniazapojený do tohto procesu a zavádza dve nové metódy leptania – vysokooxidačné bezplazmové leptanie a leptanie atómovej vrstvy (ALE) – ktoré ponúkajú nové riešenia na dosiahnutie vysokej presnosti a selektivity v SiGe leptaní.
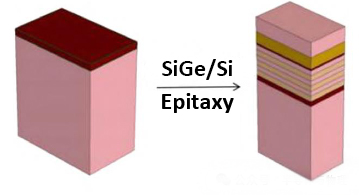
SiGe supermriežkové vrstvy v štruktúrach GAA
V dizajne GAAFETov sa na zvýšenie výkonu zariadenia striedajú vrstvy Si a SiGeepitaxne pestované na silikónovom substráte, tvoriace viacvrstvovú štruktúru známu ako supermriežka. Tieto SiGe vrstvy nielen upravujú koncentráciu nosiča, ale tiež zlepšujú mobilitu elektrónov zavedením stresu. V následných procesných krokoch je však potrebné tieto SiGe vrstvy presne odstrániť a zároveň zachovať kremíkové vrstvy, čo si vyžaduje vysoko selektívne technológie leptania.
Metódy selektívneho leptania SiGe
Leptanie bez plazmy s vysokým obsahom oxidačného plynu
Výber plynu ClF3: Táto metóda leptania využíva vysoko oxidačné plyny s extrémnou selektivitou, ako je ClF3, čím sa dosahuje pomer selektivity SiGe:Si 1000-5000. Môže sa dokončiť pri izbovej teplote bez poškodenia plazmy.
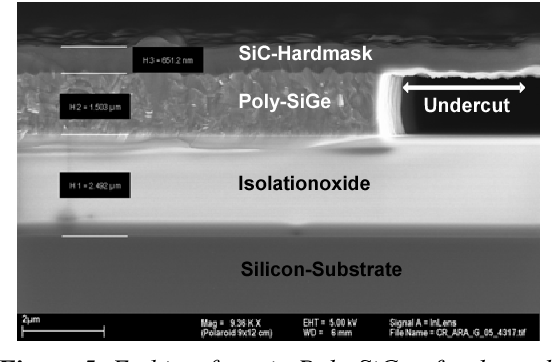
Nízkoteplotná účinnosť: Optimálna teplota je okolo 30 °C, realizácia vysoko selektívneho leptania pri nízkych teplotách, čím sa zabráni dodatočnému zvýšeniu tepelného rozpočtu, čo je rozhodujúce pre udržanie výkonu zariadenia.
Suché prostredie: celéproces leptaniasa vykonáva za úplne suchých podmienok, čím sa eliminuje riziko priľnutia konštrukcie.
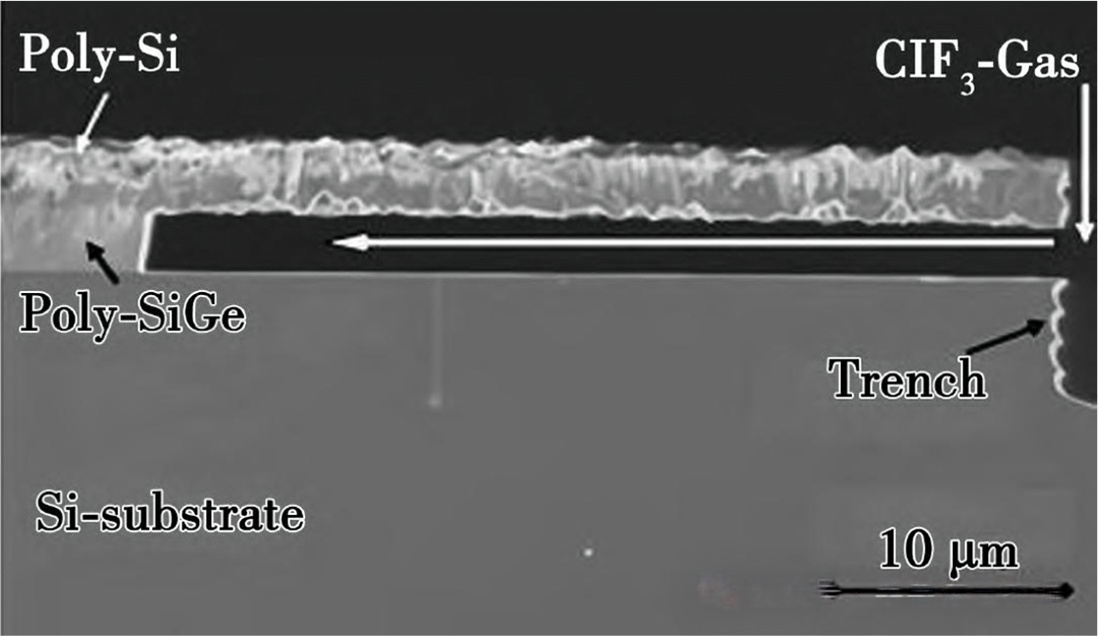
Atomic Layer Etching (ALE)
Samoobmedzujúce charakteristiky: ALE je dvojkrokový cyklický procestechnológia leptania, kde sa najskôr upraví povrch leptaného materiálu a potom sa upravená vrstva odstráni bez ovplyvnenia neupravených častí. Každý krok je samoobmedzujúci a zaisťuje presnosť na úroveň odstránenia iba niekoľkých atómových vrstiev naraz.
Cyklické leptanie: Vyššie uvedené dva kroky sa opakovane opakujú, kým sa nedosiahne požadovaná hĺbka leptania. Tento proces umožňuje ALE dosiahnuťpresné leptanie na atómovej úrovniv malých dutinách na vnútorných stenách.

My v Semicorex sa špecializujeme naGrafitové roztoky potiahnuté SiC/TaCaplikované v procesoch leptania pri výrobe polovodičov, ak máte akékoľvek otázky alebo potrebujete ďalšie podrobnosti, neváhajte nás kontaktovať.
Kontaktný telefón: +86-13567891907
E-mail: sales@semicorex.com




