
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislokácia v kryštáloch SiC
Substrát SiC môže mať mikroskopické defekty, ako je dislokácia závitovej skrutky (TSD), dislokácia závitovej hrany (TED), dislokácia základnej roviny (BPD) a ďalšie. Tieto defekty sú spôsobené odchýlkami v usporiadaní atómov na atómovej úrovni.
Kryštály SiC zvyčajne rastú spôsobom, ktorý sa rozprestiera rovnobežne s osou c alebo v malom uhle s ňou, čo znamená, že rovina c je známa aj ako základná rovina. V kryštáli existujú dva hlavné typy dislokácií. Keď je dislokačná čiara kolmá na základnú rovinu, kryštál zdedí dislokácie zo zárodočného kryštálu do epitaxne rastúceho kryštálu. Tieto dislokácie sú známe ako penetrujúce dislokácie a možno ich kategorizovať na dislokácie so závitom (TED) a dislokácie so závitom (TSD) na základe orientácie Bernoulliho vektora k dislokačnej línii. Dislokácie, kde sú dislokačné čiary aj Brönstedove vektory v základnej rovine, sa nazývajú dislokácie základnej roviny (BPD). Kryštály SiC môžu mať aj zložené dislokácie, ktoré sú kombináciou vyššie uvedených dislokácií.
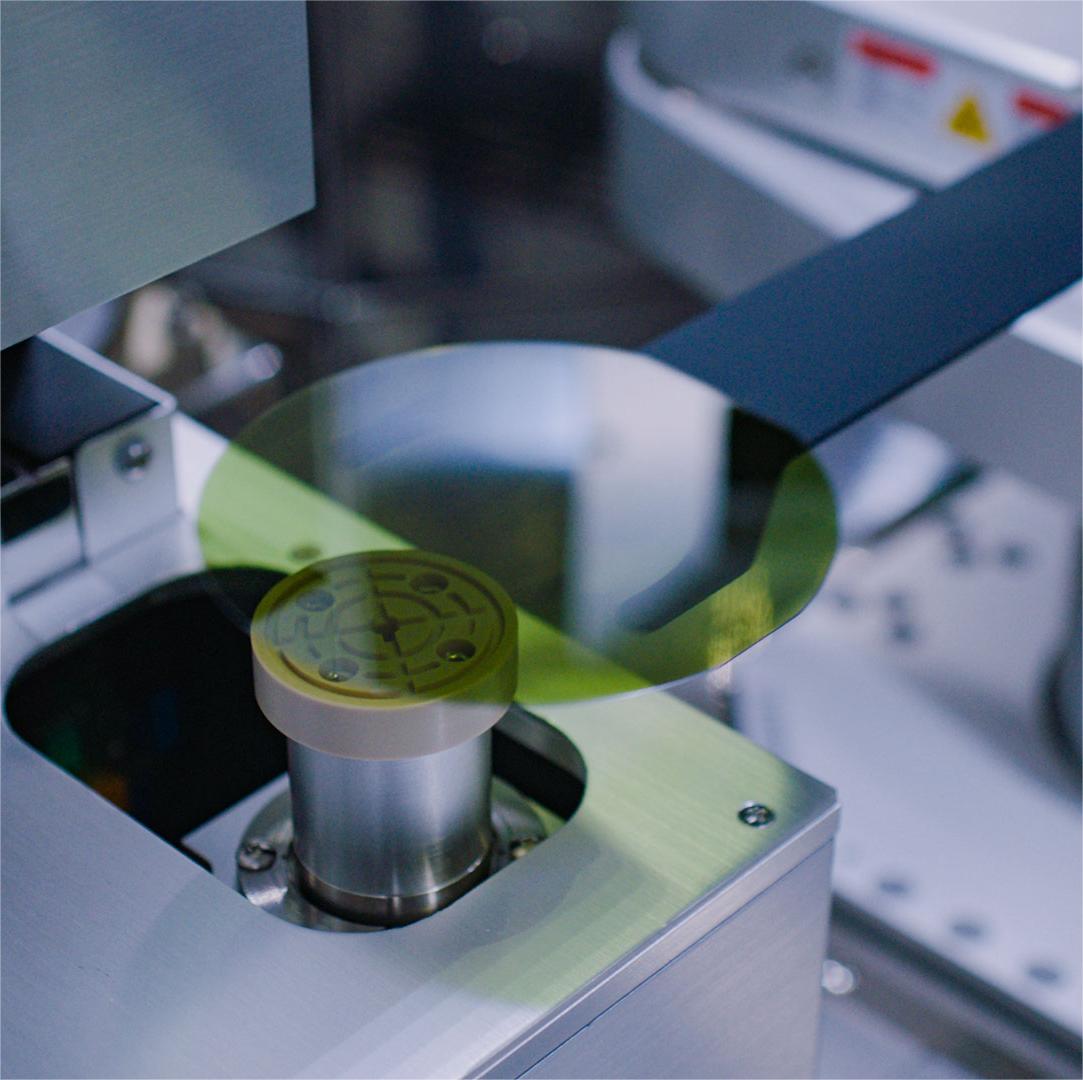
1. TED&TSD
Ako závitové dislokácie (TSD), tak závitové okrajové dislokácie (TED) prebiehajú pozdĺž osi rastu s rôznymi Burgersovými vektormi <0001> a 1/3 <11-20>, v tomto poradí.
Both TSDs and TEDs can extend from the substrate to the wafer surface and produce small pit-like surface features. Typically, the density of TEDs is about 8,000-10,000 1/cm2, which is almost 10 times that of TSDs.
Počas procesu epitaxného rastu SiC sa TSD rozprestiera od substrátu k epitaxiálnej vrstve predĺženého TSD sa môže transformovať na iné defekty na rovine substrátu a šíriť sa pozdĺž osi rastu.
Ukázalo sa, že počas epitaxného rastu SiC sa TSD transformuje na chyby stohovacej vrstvy (SF) alebo defekty mrkvy na rovine substrátu, zatiaľ čo sa ukázalo, že TED v epitaxnej vrstve je transformovaný z BPD zdedeného zo substrátu počas epitaxného rastu.
2. BPD
Dislokácie bazálnej roviny (BPD), ktoré sa nachádzajú v rovine kryštálov SiC, majú Burgersov vektor 1/3 <11-20>.
BPD sa zriedkavo objavujú na povrchu SiC doštičiek. Tie sú zvyčajne sústredené na substráte v hustote 1500 1/cm2, pričom ich hustota v epitaxiálnej vrstve je len asi 10 1/cm2.
Rozumie sa, že hustota BPD klesá so zvyšujúcou sa hrúbkou substrátu SiC. Pri skúmaní pomocou fotoluminiscencie (PL) vykazujú BPD lineárne vlastnosti. Počas procesu epitaxného rastu SiC môže byť predĺžená BPD transformovaná na SF alebo TED.
Z vyššie uvedeného je zrejmé, že v doštičke substrátu SiC sú prítomné defekty. Tieto defekty môžu byť zdedené v epitaxnom raste tenkých vrstiev, čo môže spôsobiť smrteľné poškodenie zariadenia SiC. To môže viesť k strate výhod SiC, ako je vysoké prierazné pole, vysoké spätné napätie a nízky zvodový prúd. Okrem toho to môže znížiť mieru kvalifikácie produktu a predstavovať obrovské prekážky industrializácii SiC v dôsledku zníženej spoľahlivosti.




