
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Leptaný oblátkový nosič
SEMICOREX ETCHING WAFFER Carrier s CVD SIC povlakom je pokročilé, vysokovýkonné riešenie prispôsobené náročným aplikáciám leptania polovodičov. Jeho vynikajúca tepelná stabilita, chemická odolnosť a mechanická trvanlivosť z nej robia základnú súčasť výroby modernej doštičky, čím zabezpečuje vysokú účinnosť, spoľahlivosť a nákladovú efektívnosť pre výrobcov polovodičov na celom svete.*
Odoslať dopyt
SEMICOREX ETCHING WAFER Carrier je vysokoúčinná podporná platforma substrátu určená pre procesy výroby polovodičov, konkrétne pre aplikácie leptania doštičiek. Tento nosič s vysokou čistotou grafitou a potiahnutý chemickým ukladaním chemickej pary (CVD) (SIC), poskytuje výnimočný chemický odpor, tepelnú stabilitu a mechanickú trvanlivosť, zabezpečujúc optimálny výkon v prostredí vysoko presného leptania.
Leptacia doštička je potiahnutá rovnomernou vrstvou CVD SIC, ktorá významne zvyšuje jej chemický odpor proti agresívnym plazmovým a korozívnym plynom používaným v procese leptania. CVD je v súčasnosti hlavnou technológiou prípravy povlaku SIC na povrchu substrátu. Hlavným procesom je, že suroviny reaktantov v plynnej fáze prechádzajú sériou fyzikálnych a chemických reakcií na povrchu substrátu a nakoniec ukladajú na povrch substrátu na prípravu povlaku SIC. Náter SIC pripravený technológiou CVD je úzko spojený s povrchom substrátu, ktorý môže účinne zlepšiť oxidačnú rezistenciu a abláciu substrátového materiálu, ale čas ukladania tejto metódy je dlhý a reakčný plyn obsahuje určité toxické plyny.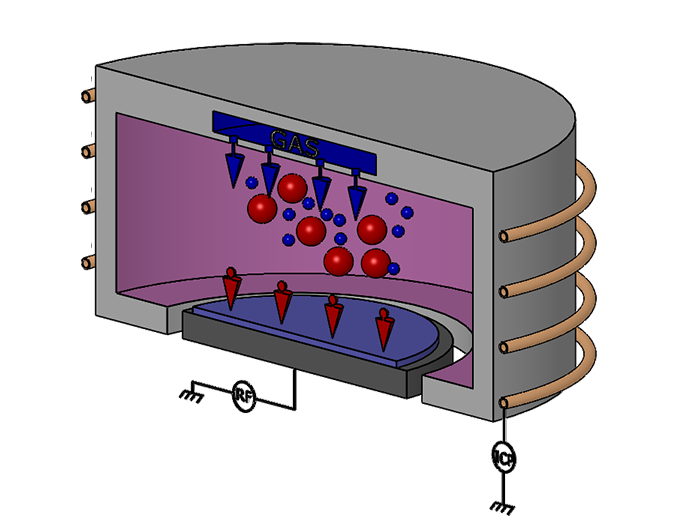
CVD kremíkový karbidový náterČasti sa široko používajú pri leptaní zariadení, MOCVD zariadeniach, epitaxiálnych zariadeniach SI a epitaxiálne vybavenie SIC, rýchleho tepelného spracovateľského zariadenia a ďalších polí. Celkovo je najväčším trhovým segmentom častí potiahnutia karbidu kremíka CVD leptania a diely epitaxiálneho vybavenia. V dôsledku nízkej reaktivity a vodivosti povlaku karbidu kremíka CVD na leptacie plyny obsahujúce chlór a fluór sa stáva ideálnym materiálom na zaostrenie krúžkov a iných častí leptania v plazme.Časti CVD SICv leptaní zariadenia patrízaostrovanie prsteňov, plynová sprcha hlavy, podnosy,obrusové krúžkyatď. Zameriava sa ako príklad zaostrenie. Zaostrený krúžok je dôležitou súčasťou umiestnenou mimo oblátky a v priamom kontakte s oblátkou. Napätie sa aplikuje na kruh na zaostrenie plazmy prechádzajúcej krúžkom, čím sa zameriava plazma na doštičku, aby sa zlepšila rovnomernosť spracovania. Tradičné zaostrené prstene sú vyrobené zo kremíka alebo kremeňa. S rozvojom integrovanej miniaturizácie obvodu sa zvyšuje dopyt a význam leptania procesov pri výrobe integrovaných obvodov a naďalej sa zvyšuje energia a energia leptania.
Povlak SIC ponúka vynikajúcu odolnosť proti fluórovým (F₂) a chlórskym leptaniam na báze chlóru (CL₂), čím sa bráni degradácii a udržiava štrukturálnu integritu pri predĺženom používaní. Táto chemická robustnosť zabezpečuje konzistentný výkon a znižuje riziká kontaminácie počas spracovania doštičiek. Oblátka môže byť prispôsobená rôznym veľkostiam oblátkov (napr. 200 mm, 300 mm) a špecifickým požiadavkám na leptanie. K dispozícii sú vlastné konštrukcie slotov a vzory otvorov na optimalizáciu polohy oblátky, riadenia prietoku plynu a účinnosti procesu.
Aplikácie a výhody
Nosič doštičiek na leptanie sa používa primárne pri výrobe polovodičov na procesy suchého leptania vrátane leptania plazmy (PE), reaktívneho leptania iónov (RIE) a hlbokého reaktívneho leptania iónov (DRIE). Vo všeobecnosti sa prijíma pri výrobe integrovaných obvodov (ICS), zariadení MEMS, výkonovej elektroniky a doštičiek polovodičov. Jeho robustné povlaky SIC zaisťuje konzistentné výsledky leptania tým, že zabránia degradácii materiálu. Kombinácia grafitu a SIC poskytuje dlhodobú trvanlivosť, znižuje náklady na údržbu a výmenu. Hladký a hustý povrch SIC minimalizuje tvorbu častíc, čím zabezpečuje vysoký výťažok do oblátky a vynikajúci výkon zariadenia. Výnimočná odolnosť voči tvrdým leptacom prostredia znižuje potrebu častých výmen, čím sa zlepšuje výrobná účinnosť.













